QFN封装(qfn封装怎么焊接)
日期:2023年08月24日 13:30 浏览量:1
来源:本文由公众号半导体行业观察(ID:icbank)翻译自「semiwiki」,谢谢。
简介
半导体芯片封装技术经过多年的发展,今天已有数百种封装类型。
大多数应用需要更通用的单个元件封装,用于封装集成电路和其他元件,如电阻器,电容器,天线等。然而,随着半导体行业开发出更小、更强大的器件,“系统封装”(SiP)类型的解决方案正在成为首选,即所有元件都放在一个单独的封装或模组中。
虽然封装类型可以很容易地分为引线框架封装、基板封装或晶圆级封装,但选择适合你所有需求的封装则要复杂一些,需要评估和平衡应用需求。要做出正确的选择,你必须了解多个参数的影响,比如热需求、功率、连接性、环境条件、PCB组装能力,当然还有成本。
本文介绍了需要评估的七个不同的关键要求,以便选择合适的封装技术。


常用封装技术
多年来,封装技术不断发展,今天,通过使用不同的连接和组装方法,有多种封装类型可供选用。本文主要讨论目前最常用的四种封装:BGA、QFN、WLCSP和eWLB。
BGA(球栅阵列)是一种封装选择,适用于需要大量I/O连接的IC。BGA的优点包括低电感和良好的散热选择。缺点是,检测和故障检测比较困难,与QFN等其它封装相比,成本可能更高。
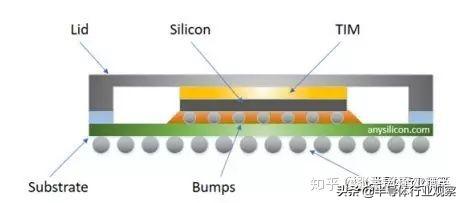
图片来源:http://anysilicon.com
QFN(方形扁平无引脚封装)是目前最受欢迎的半导体封装之一,它成本低,外形小巧,电气性能和热性能良好。QFN的缺点包括引脚数量少、潜在的氧化问题,以及在长寿命、恶劣环境下的可靠性。
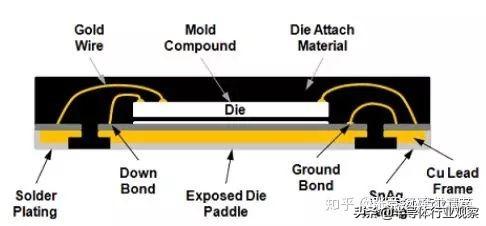
图片来源:http://mentor.com
WLCSP(扇入式晶圆级CSP)本质上是一个凸起的裸片,因此可以提供尽可能小的封装尺寸,因为它与芯片尺寸相同。WLCSP具有合理的低成本、小尺寸和良好的电气性能,但可能不太适合高引脚数量的应用。
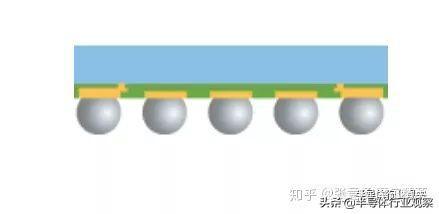
图片来源:http://statschippac.com
eWLB(嵌入式晶圆级球栅阵列)在原始晶圆下使用内插晶圆,以实现扇出和更多的互连布线空间。这样就产生了更大的裸片面积,解决了WLCSP的互连问题。eWLB正在成为消费ASIC和无线ASIC的首选。
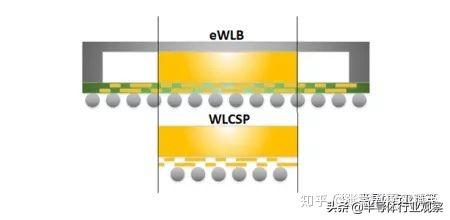
图片来源:http://anysilicon.com
应用类别:成本vs性能
你的目标应用是决定封装选择的主要驱动力。你的应用环境如何?你是在芯片上开发一个系统,还是将ASIC作为系统中的一个关键组件?
这些问题将会帮助你决定封装的类型——你是否可以使用晶圆级或芯片大小的封装,还是使用标准的、更容易获得的BGA或QFN类型的封装更合适?
应用性能要求和相应的封装选项大致可分为三类:
高端应用要求通常与具有大量连接(大量引脚输出)的高速、高功率芯片有关。这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装,例如嵌入式晶圆级球栅阵列(eWLB)实现。
中端应用通常需要能够解决热增强问题,并采用具有成本效益的塑料封装技术——通常采用BGA和QFN封装。中端应用中的高端是芯片级和晶圆级封装,适用于系统封装和多芯片模组封装。
入门级应用包括高产量应用,此时成本是主要驱动因素,而不是性能。例如,用于笔记本和手机应用的器件通常需要较小尺寸的晶圆级和芯片尺寸封装。
引脚和I/O的数量
在确定封装要求时,器件的输入和输出连接的数量和位置是要考虑的关键因素。此外,在电源连接、高速数据输入和输出、接地连接以及控制和监控信号等方面,需要明确识别互连类型,并与芯片和封装布局相关。
引脚数多。如果你的引脚数非常多,比如1000引脚的封装,那么你最好的选择可能是标准BGA封装,它提供了这样的I/O能力,因为整体封装尺寸可以达到50~60平方毫米。
引脚数少。对于低引脚数,例如50引脚,此时你的选择可能是QFN或WLCSP封装。然而,WLCSP对封装内的散热有限制。在有热量产生(例如,快速开关)或需要良好的信号接地的情况下,QFN是更好的封装选择,因为它有“内置”的金属base pad。
布局。另一个参数是I / O的位置。如果I / O位于裸片周围的外围,那么只要裸片和封装焊盘有足够的表面积,就可以快速、简单和可靠地进行引线键合。如果I/O分布在芯片表面的不同区域,使得从芯片的中心向外键合很困难,那么倒装芯片封装就提供了一种直接连接到封装基板(通常是多层PCB)的方法,不会出现裸片重叠的问题。
热管理
芯片技术的进步使得人们不断生产出体积更小、速度更快的芯片,这意味着芯片也在产生更多的热量。因此,热管理是优化芯片性能的关键封装因素。
热管理保证了芯片的可靠性和持久运行。例如,如果温度保持在较低水平,互连(如芯片粘接材料,引线键合或倒装芯片球)更可靠。例如,如果使用环氧树脂将ASIC芯片放置在基板上,然后温度过高,环氧树脂就会软化并可能熔化,从而让ASIC产生物理移动,导致封装变得不可靠。过热也可能对RF频率产生负面影响,并降低器件性能。
热管理也是成本因素之一,它取决于所选器件和封装的类型。不同的散热工艺和方法与不同的封装类型相关联。例如,BGA封装通常可以在封装中提供更低的成本和更好的热管理解决方案,因为它具有更大的面积可用于散热。面积较小的芯片往往会产生热环境,在热管理解决方案方面可能更昂贵,需要外部散热器或其他冷却选择。
BGA封装有两种导热pad可选,例如导电通孔或内置金属基板,可实现充分的热管理。热增强型BGA封装的一些选择可以在其上构建金属cap,从而在IC器件和金属cap之间建立导热路径,提供良好的散热。
QFN封装的设计使得它们具有固体金属芯片pad作为封装的基底,裸片与之结合。这使得从芯片到PCB的散热非常好。
裸片附加材料。使用导热粘合剂(如银填充的环氧树脂,而不是普通环氧树脂)将芯片粘合到基板上,有助于消除热量。此外,还有一些新技术,如银烧结技术,一种具有高工作温度、高热导率和高导电性的互连方法。这些材料通常在QFN封装中效果很好,但由于封装结构的原因,在BGA封装中效果不佳。
芯片尺寸和晶圆级封装。这些封装中的热管理主要是在芯片的背面或芯片尺寸的封装中, 在暴露在外的芯片顶部完成的。
高速信号/射频
射频、无线和高速数字设计有特定的要求,影响封装的选择。封装内互连的参数效应可显着降低信号速度和频率。
引线键合vs倒装芯片。在射频器件中,关键的设计考虑因素包括电感、电容和电阻,这些因素受进出器件的信号速度的影响。这些问题也影响封装选择,主要是在倒装芯片和引线键合互连之间。倒装芯片会提供更好的射频性能,并能够以更低的电感达到更高的频率。另一方面,引线键合可以在每个射频输入或输出频率较高的地方添加随机变化的电感。
封装布局。在射频频率下,信号沿表面而不是在导体中传播。因此,封装的方式对器件有重要的影响。例如,高速放大器芯片、射频晶体管和二极管通常不能放入“标准”塑料封装中,因为封装材料会影响芯片的运行速度。因此,这种芯片应该放进cavity QFN或BGA封装。
高频信号(1GHz及以上)可能要求互连的布局具有隔离的信号路径,即所谓的“接地—信号—接地”互连。此处,对每个信号I/O的两个接地连接的要求将影响封装的大小和布局。
此外,对于高速ASIC,信号电平和定时将受到它们所经过的导体的长度的影响。例如,如果你使用的是BGA封装,并且有一个较长的引脚指向一个点,一个较短的引脚指向下一个点,那么信号的时序差异会很大。必须通过更多地考虑封装基板的初始设计以适应高速射频器件来克服这一点。
BGA衬底介电材料也是射频芯片的关键因素。例如,高性能液体聚合物基板(如Rogers层压板)比标准FR4 PCB材料更适合用作射频设计中BGA封装的基板。
PCB组装
PCB组装和将封装的ASIC芯片连接到电路板的方法需要几个可能影响可靠性的工艺,因此在决定ASIC封装时应事先考虑这些工艺。
根据选择的封装类型,你需要确保找到具有正确PCB组装工艺的供应商,以确保你完成的项目具有最高质量。高级封装组件不能由任何电子制造服务公司处理。你的选择应该能够适应合适的间距,无论是小封装和大封装尺寸。
例如,芯片尺寸封装、晶圆级封装,当然还有裸片倒装芯片,都需要加热和压力工艺才能将它们直接连接到PCB上。因此,组装者需要具备先进的PCB组装能力,以实现准确的位置处理和合适的先进工艺,以确保这些小尺寸部件可靠地连接到电路板上。
另一方面,如果封装是具有小球间距(例如,0.5mm或更小)的多I / O球栅阵列(BGA)封装,则该工艺需要高质量的PCB组装能力,具有高精度的校准和专业的焊接工艺,以产生可靠和鲁棒的结果。
QFN封装具有许多优点,但它们在PCB级别也存在一些重要的制造和可靠性问题,因此它们还需要更多的专业工艺来进行组装。由于封装采用带有外围接触pad的金属“嵌条(slug)”基板,组装过程容易产生缺陷,如短路、空洞、开口和填充缺陷等,当它与无铅焊接工艺结合使用时,形成空洞的问题就变得更加困难。
环境考虑因素
特定的环境或机械需求往往决定了应用所需的封装类型。消费类产品具有最简单的要求(见下表),因为封装往往受成本驱动,而不是环境驱动。此时塑料封装选是首选,但即使在这里,抗冲击和抗振动需求也是可用类型的限制因素。
然而,如果所选择的应用和系统需要保护免受潮湿或化学影响,如在许多医疗和航空航天应用中,对封装气密性的需求是驱动因素。在这种情况下,唯一的选择可能是使用特定类型的封装,例如密封金属或陶瓷封装,以保护ASIC器件。
在汽车应用中,封装需要能够承受温度、振动和冲击的水平现在已经达到了国防和航空航天的要求(参见MIL标准)。然而,由于成本是汽车的一个关键驱动因素,汽车行业已经提高了标准封装的性能,使QFN和某些BGA类型的零部件能够被接受。
在航天工业中,下一代太空舱和卫星需要高速、低成本的ASIC器件。在这里,应用要求封装低成本、重量轻,但也能承受高重力、机械冲击和压力。潜在的解决方案可能是塑料封装,尽管这些类型不是密封的。这种需要促使这些应用寻找新方法来密封整个系统,以克服封装缺陷。
下表提供了不同行业的一些环境要求和一些潜在的封装解决方案的示例。
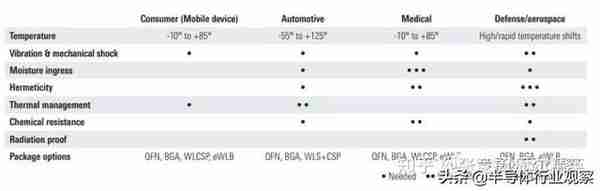
特定应用要求
在大多数情况下,特定应用要求将决定封装类型和封装形式。然而,许多新应用,例如手持设备,具有晶圆级功能的下一代ASIC器件,例如硅通孔(TSV),可能不需要封装。在这种情况下,将采用直接裸片连接/倒装芯片工艺。
ASIC通常支持诸如传感器和LED之类的功能器件,在这些器件中,封装不是上述类型的标准,但电子产品的封装或外壳必须适合应用所定义的特定形状和空间。汽车、航空航天和工业中的典型应用可采用这种方法。例如,ASIC芯片可能需要适合特定空间,例如电源模块或传感器控制系统外壳。
在其他情况下,例如在构建汽车模组时,可以使用系统级封装(SiP),将多个IC与外围器件捆绑在一个整体封装中。此处可以使用定制陶瓷封装,例如Pin Grid阵列或金属can模组封装。
下一代SiP和新兴应用正在考虑使用三维封装技术,如模塑互连器件(3DMID)和3D多层堆叠封装单元,这些都是针对特定应用解决方案的定制设计。
推荐阅读

-
芜湖哪里好玩(芜湖哪里好玩便宜的地方)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...

-
电影票哪里买(电影票哪里买最便宜)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...

-
h55主板(h55主板支持几代cpu)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...

-
中国稀有稀土有限公司(中国稀有稀土有限公司是国企吗)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...

-
融资租赁公司工作内容(融资租赁公司累吗)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...

-
莲塘(莲塘口岸去香港攻略)
2023-08-24
这些器件需要先进的封装要求,以满足小焊盘间距、高速信号和解耦的需求,这可以通过FC-BGA(倒装芯片BGA)或更新的封装...
